|
超净室仪器设备
ICP(ICP 180 OXFORD)
背景:
通入反应气体使用电感耦合等离子体辉光放电将其分解,产生的具有强化学活性的等离子 体在电场的加速作用下移动到样品表面,对样品表面既进行化学反应生成挥发性气体,又有一定的物理刻蚀作用。因为等离子体源与射频加速源分离,所以等离子体 密度可以更高,加速能力也可以加强,以获得更高的刻蚀速率,以及更好的各向异性刻蚀。另外,由于该系统使用了Cl基和Br基的刻蚀气体,因此该ICP系统适合于对Ⅲ-Ⅴ族化合物材料进行刻蚀。
技术指标:
ICP离子源:0-3000W
RF射频源:0-600W
装片:1片四英寸,向下兼容
基底刻蚀温度:0℃-200℃可调。
刻蚀气体:BCl3、Cl2、HBr、Ar、O2
可刻蚀材料包括:GaN、GaAs、InP等Ⅲ-Ⅴ族化合物材料
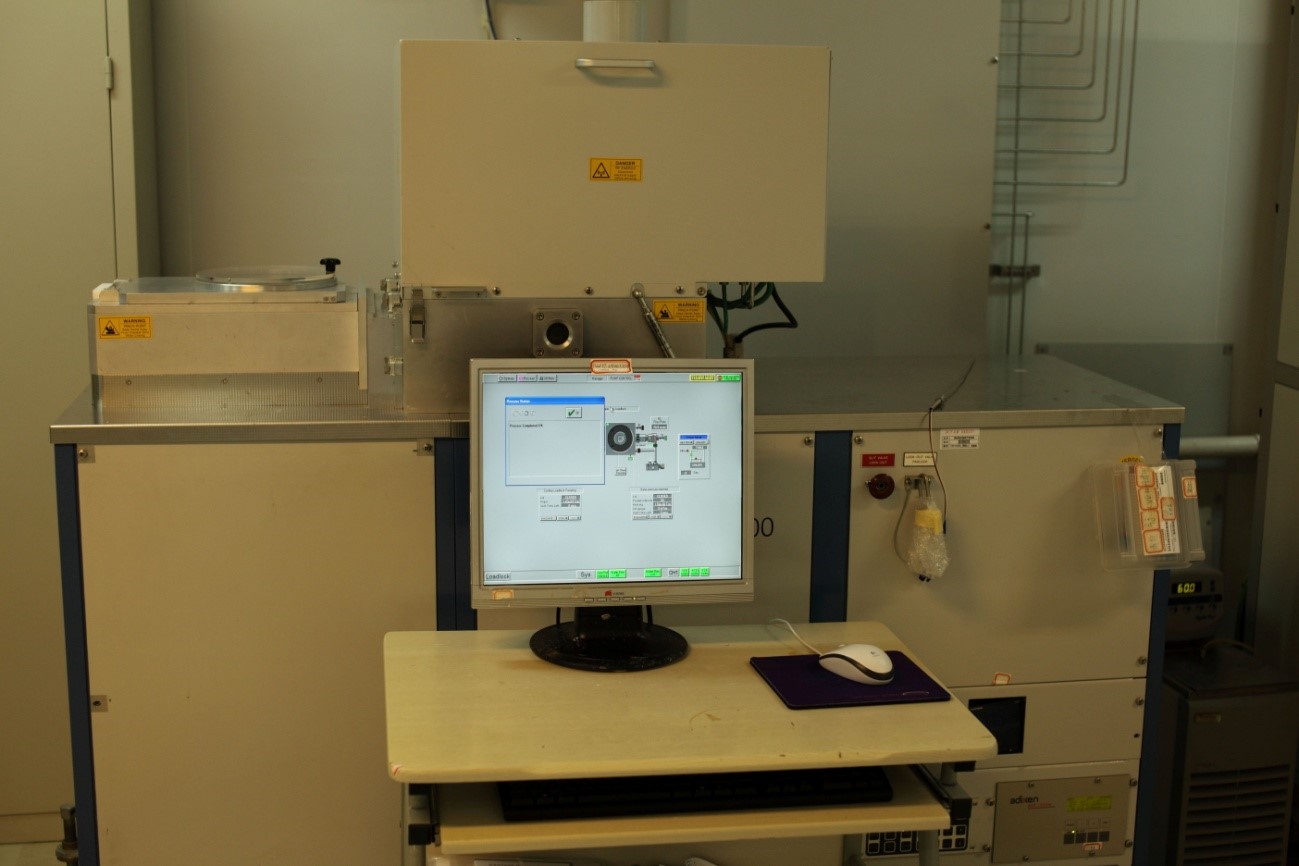
ICP(Multiplex ICP STS)
背景:
通入反应气体使用电感耦合等离子体辉光放电将其分解,产生的具有强化学活性的等离子 体在电场的加速作用下移动到样品表面,对样品表面既进行化学反应生成挥发性气体,又有一定的物理刻蚀作用。因为等离子体源与射频加速源分离,所以等离子体 密度可以更高,加速能力也可以加强,以获得更高的刻蚀速率,以及更好的各向异性刻蚀。该系统使用了F基的刻蚀气体,具有Bosch工艺,适合于对硅材料进行大深宽比刻蚀。
技术指标:
ICP离子源:0-3000W
RF射频源:0-600W
装片系统:六英寸,向下兼容
基底刻蚀温度:0℃-200℃可调。
刻蚀气体:SF6、C4F8、O2、Ar
可刻蚀材料包括:硅材料
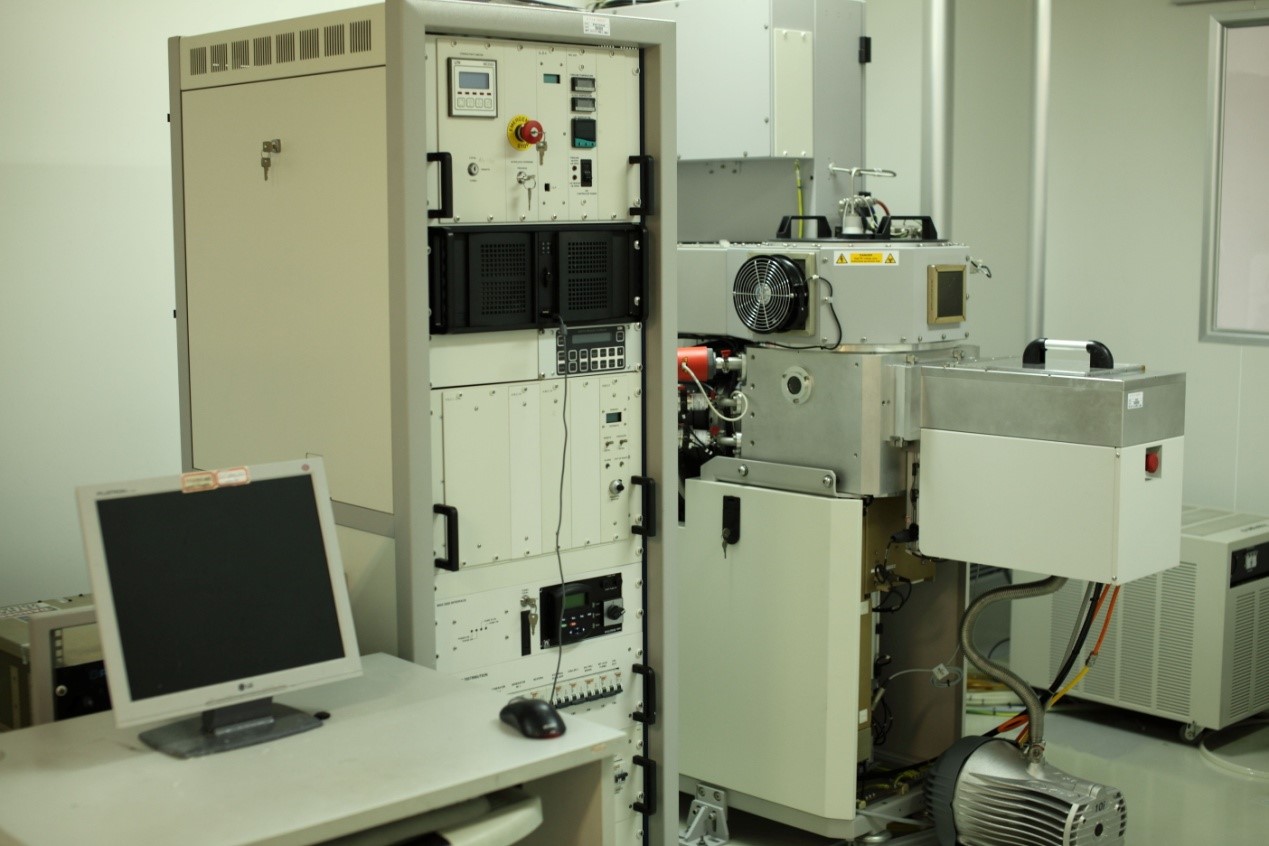
PECVD(Multiplex PECVD STS)
背景:
等离子体增强化学气相沉积(PECVD)技术是借助于辉光放电等离子体使含有薄膜组成的气态物质发生化学反应, 从而实现薄膜材料生长的一种新的制备技术。由于 PECVD 技术是通过反应气体放电来制备薄膜的,有效地利用了非平衡等离子体的反应特征,从根本上改变了反应体系的能量供给方式。 一般说来,采用 PECVD 技术制备薄膜材料时, 薄膜的生长主要包含以下三个基本过程:首先,在非平衡等离子体中,电子与反应气体发生初级反应,使得反应气体发生分解,形成离子和活性基团的混合物; 其二,各种活性基团向薄膜生长表面和管壁扩散输运,同时发生各反应物之间的次级反应;最后,到达生长表面的各种初级反应和次级反应产物被吸附并与表面发生反应,同时伴随有气相分子物的再放出。
技术指标:
可沉积厚达十几个微米的SiO2;
淀积低应力SiN和SiON等介质膜;
淀积速率:>150nm/min(SiO2);>100nm/min(SiN);
厚度控制:从几十nm到6um都可精确控制。
均匀性好:<±3%;重复性好:<±3%;应力小:<300MPa;表面平整度、致密性好;
上下电极加热:上电极250℃,下电极300℃,可以减小侧壁和上电极沉积物的脱落。

台阶仪(DEKTAK 150 VEECO)
背景:
当触针沿被测表面轻轻滑过时,由于表面有微小的峰谷使触针在滑行的同时,还沿峰谷作 上下运动。触针的运动情况就反映了表面轮廓的情况。传感器输出的电信号经测量电桥后,输出与触针偏离平衡位置的位移成正比的调幅信号。经放大与相敏整流 后,可将位移信号从调幅信号中解调出来,得到放大了的与触针位移成正比的缓慢变化信号。
技术指标:
1、扫描长度:55mm;
2、垂直测量范围:524um(标准),最大可达1mm;
3、台阶高度重现性6Å, 1 在1um台阶上;
4、垂直分辨率:1Å,(6.55um范围) ;
5、探针压力:1-15mg,最小可达1mg;
6、探针曲率半径:0.2-25um,超细探针50nm;
7、样品台尺寸:150mm,可360°旋转。

六英寸双面对准光刻机(MA6/BA6 SUSS)
背景
SUSSMA6光刻机是设计用于实验室研发,小批量生产的高分辨率光刻系统。该光刻机供了最好的基片适应性,可夹持不同厚度不同形状的晶片。同时标准尺寸基片最大直径为150mm。处理最大厚度可达6mm的晶片。SUSS MA6提供了各种接触式曝光程序。X-和Y-向位移精度在0.1μm以下。使用400nm的宽带光源曝光波长在真空模式下分辨率为0.7μm。同时可以选用不同的对准装置,分离视场顶部对准显微镜或视频显微镜,BSA底面对准显微镜对准方式。是目前实验室光刻技术中最为常用和重要的光刻设备。
技术指标:
Wafer size: 2inch,4inch,6inch and un-normal small wafers
Exposure mode:(Vac, hard, soft, proximity)
Minimum line width:0.7μm(Vac)
Overlay Accuracy: 0.5μm
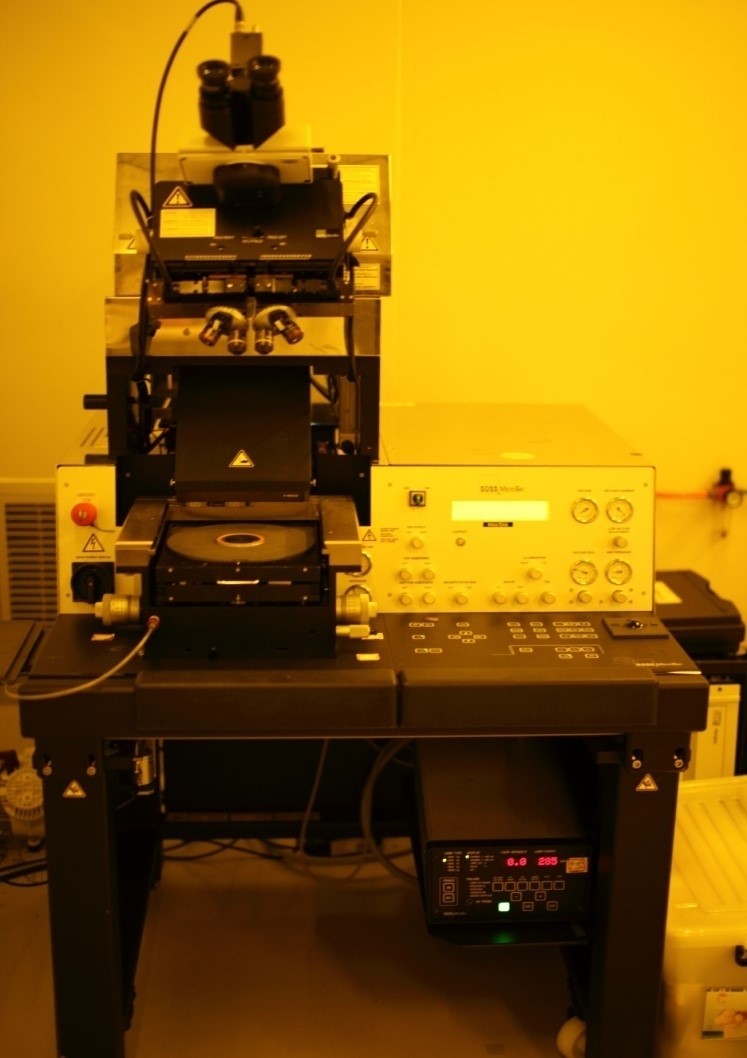
磁控溅射镀膜机(PVD 75 Kurt J.Lesker)
背景
磁溅射镀膜机是一种普适镀膜机,用于各种单层膜、多层膜和掺杂膜系。可镀各种硬质膜、金属膜、合金、化合物、半导体、陶瓷膜、介质复合膜和其他化学反应膜,亦可镀铁磁材料。主要用于实验室制备有机光电器件的金属电极及介电层,以及制备用于生长纳米材料的催化剂薄膜层。
技术指标:
1、配装3支Ф2英寸的磁控溅射靶,其中一支可镀铁磁材料.
2、磁控溅射靶射频(RF)、直流(DC)兼容.
3、每只磁控溅射靶均配备挡板,基片配挡板.
4、极限真空:5*10-5Pa;工作背景真空:7*10-4Pa .
5、基片尺寸≤Ф4英寸.
6、基片可加热至500℃.
7、控制系统:PC+PLC全自动控制.
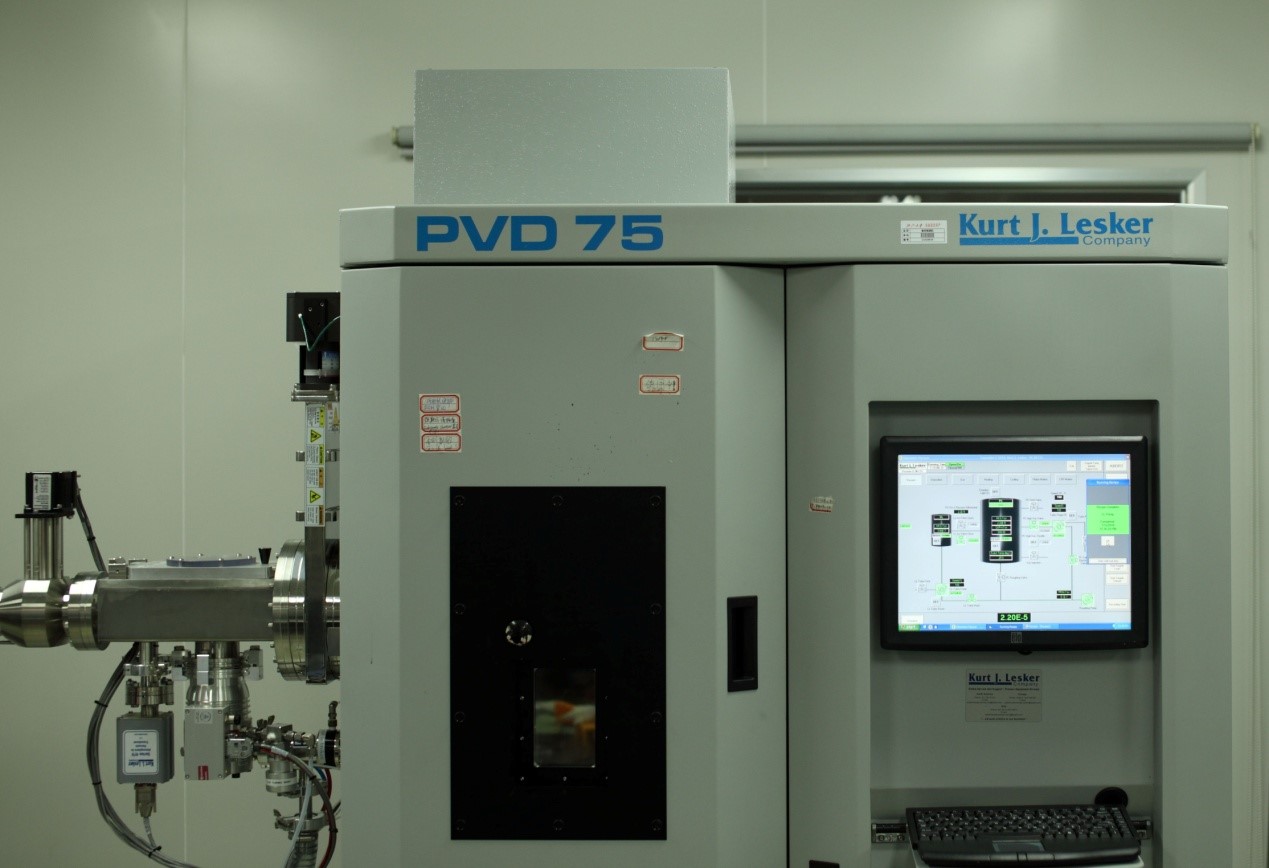
电子束曝光机(Raith150-TWO)
背景
电子束曝光是在扫描电子显微镜的基础上,再集成一个由计算机自动控制的图形生成部分,从而能够控制聚焦电子束扫描任何需要的图形区域。利用某些对电子敏感的高分子聚合物作光刻胶,通过聚焦电子束对其曝光(改性),从而在显影后实现各种掩模图形。电子束曝光无需掩膜,可实现低至10nm线宽图形,在纳米加工中是一种非常灵活方便的曝光工具,特别适合科学研究领域。
技术指标
- Accelerating voltage: 5~30 kV
- Minimum line width: 10 nm
- Overlay Accuracy: 40 nm
- Field stitching Accuracy: 20 nm
- Exposure range: 直径75 mm
- Scan speed:12 MHz to 250 Hz
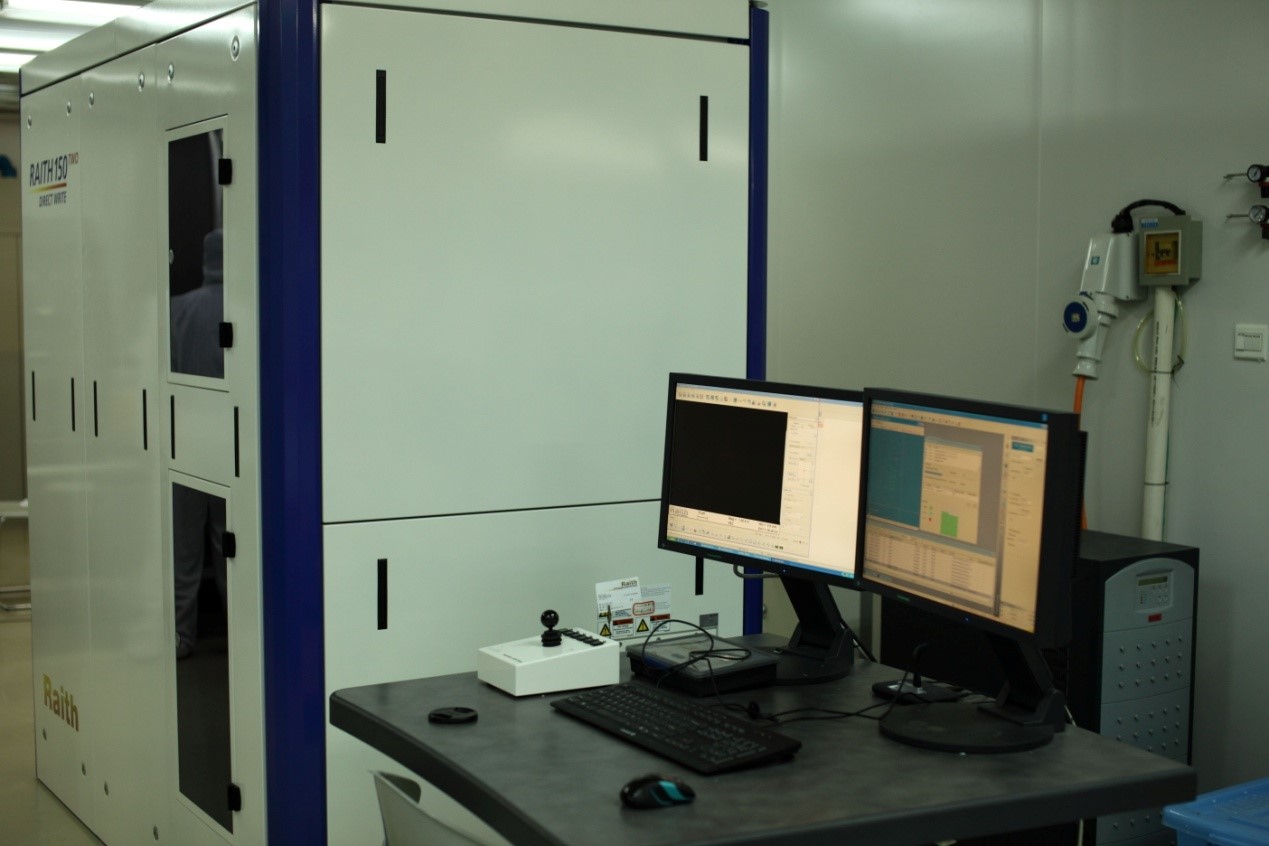
电子束蒸发镀膜机
背景
电子束蒸发镀膜机是一种普适镀膜机,用于镀制各种单层膜、多层膜。可镀各种硬质膜、金属膜。主要用于制备纳米器件、有机光电器件的金属电极,以及制备用于生长纳米材料的催化剂薄膜层。
技术指标
1. 基片尺寸=Ф4英寸
2. 极限真空度:5×10-5Pa
3. 真空抽速:3*10-4Pa/20min
4. 衬底温度:350℃
5. 温度均匀性:±10℃
6. 样平台转速:≤20r/min
7. 坩埚数量:3

超净室仪器设备收费标准
设备名称 |
收费标准 |
EBEAM电子束曝光机
RAITH-150 II |
校外1200元/小时
校内800元/小时 |
紫外光刻机
MA6 |
校外800元/小时
校内600元/小时 |
感应等离子刻蚀机
STS ICP |
校外800元/小时
校内600元/小时 |
等离子体增强化学气相沉积STS PECVD |
校外800元/小时
校内600元/小时 |
激光直写
Heidelberg DWL 66 |
5小时内600元,超过部分每增加1小时加收100元 |
磁控溅射
Kurt Lesker |
300元/次开机+450元/小时+材料费: 50元/10nm(Au及合金、Pd)或75元/10nm(Pt) 或50元/100nm |
Vecco deltak台阶仪 |
30元/点 |
棱镜耦合仪 |
50元/点 |
氧化或退火 |
500元/小时 |
(1)所有以时间为计量单位的仪器,以半小时为计量单位,不足半小时按半小时计;
(2)PECVD、ICP、EBL、sputtering的时间计量以load片为开始,unload出片子为结束计时;
|



